1、MOSFET 简介
MOSFET,全称Metal-Oxide-Semiconductor Field-Effect Transistor,即金属-氧化物半导体场效应晶体管,广泛使用在模拟电路与数字电路。
- 分类
按照沟道类型分为NMOS和PMOS。根据场效应原理的不同,又分为耗尽型和增强型。
按照工艺和技术要求,又分为平面MOS和超结MOS。
由于工艺的问题,MOS的内部会寄生一个二极管,有的场合不需要这个二极管,但是在有的应用上,比如LLC电路,则对寄生的二极管提出了很高的要求。
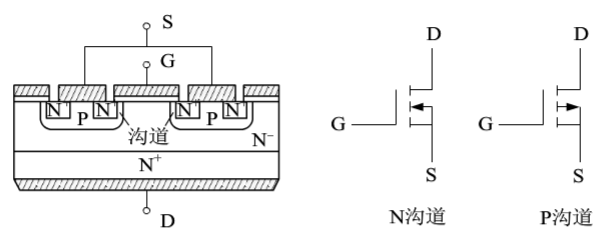
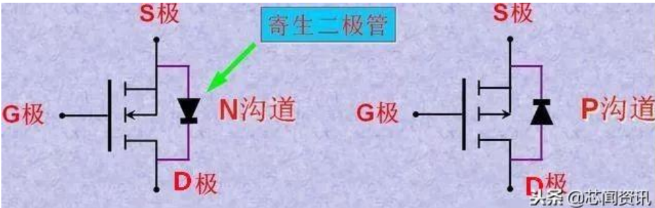
- 封装

MOS的封装主要有TO220,TO220F,TO-263,TO252.
其晶圆的大小和参数是一样的,但是由于封装的不同,造成散热能力不同,也就是过电流能力的不同。
与封装有关的参数见下表:

AOT380A60L是TO220封装,AOTF380A60L是TO220F封装,虽然晶圆一样,但是TO220封装的耗散功率和Rθjc参数就要比TO220F好很多。但是由于TO220F封装是塑封的,在用到散热片的情况下,不需要绝缘垫片,加工工艺就简单得多,且更加可靠。
- 主要参数解析
|
Symbol |
Parameter |
中文描述 |
对电源影响 |
|
VDSS |
Drain-Source Voltage |
漏源电压标称值 |
此参数并不是越大越好,在余量足够情况下尽量小一些,以获得较小的导通电阻和较低的成本。 |
|
ID |
Continuous DrainCurrent (TC=25°C) |
漏源标称电流 |
漏源间可承受的电流值,如果偏小,在设计时如果降额不是很充裕,那么在上载,短路测试,过载测试的时候,可能击穿MOSFET。 |
|
Continuous DrainCurrent (TC=100°C) | |||
|
IDM |
Pulsed Drain Current C |
漏源最大脉冲电流 |
漏源间可承受的单次脉冲电流值,如果参数过小,在短路和过载测试时,会击穿MOS。 |
|
VGS |
Gate-Source Voltage |
栅源电压 |
栅极可承受的最大电压范围,必须保证,Vgs电压一直在其规格范围内,电压过低不能打开MOS,过高损坏MOS。MOS的栅极比较脆弱。 |
|
EAS |
Single pulsed avalanche energy |
单脉冲雪崩能量 |
MOS漏源间承受的最大单次或多次脉冲的能量。反映了MOS的强壮与否。需要有足够的强度抵抗大的电流,电压,浪涌等对MOS的冲击。 |
|
EAR |
Repetitive avalanche energy |
重复雪崩能量 | |
|
dv/dt |
MOSFET dv/dt ruggedness |
MOEFET 电压上升能力 |
1, dv/dt反映了MOS承受电压变化速率的能力,越大越好。 |
|
Peak diode recovery dv/dt |
漏源寄生二极管恢复电压上升速率 |
2, 但过高的dv/dt会引起过高的电压,造成EMC(EMI)较差,需要进行参数调整。 | |
|
PD |
Power Dissipation (TC=25°C) |
最大耗散功率 |
此参数越大越好,因为测试条件过于理想,因此仅仅具有参考价值。参考时要考虑实际的散热情况。 |
|
Power Dissipation (Derate above 25°C) | |||
|
TSTG,TJ |
Junction and Storage Temperature Range |
结温和贮存温度 |
此参数表明MOS的温度承受能力。越大越好。越大代表此MOS可承受更大的功率。 |
|
TL |
Maximum lead temperature for soldering purpose, 1/8" from case for 5 seconds |
最大引线焊接温度 |
表明插件器件焊接时的温度承受能力。 |
|
Rθjc |
Maximum Junction-to-Case |
PN接到封装的热阻 |
此参数反映了在相同条件下的器件散热的能力。热阻越小,散热能力越好。但是也要考虑工作的环境,比如散热器的大小,通风等条件。 |
|
Rθcs |
Maximum Case-to-sink |
封装到散热器的热阻 | |
|
Rθja |
Maximum Junction-to-Ambient |
PN接到环境的热阻 | |
|
IS |
Maximum Body-Diode Continuous Current |
MOS 体二极管最大连续电流 |
此参数在一般的应用中用不到,有时候还起到不好的作用,但是在一些特殊电路比如LLC电路,需要此参数足够强大,要和MOS一样。 |
|
ISM |
Maximum Body-Diode Pulsed Current |
MOS 体二极管最大单脉冲电流 | |
|
VSD |
Diode Forward Voltage |
体二极管正向压降 |
压降过大则流过一定电流后功率比较大,发热严重。 |
|
Trr |
Body Diode Reverse Recovery Time |
体二极管反向恢复时间 |
如果反向恢复时间较长,则在LLC等电路中会产生较大功耗,同时会造成上管和下管同时导通,MOSFET因电流过大损坏。 |
|
Qrr |
Body Diode Reverse Recovery Charge |
体二极管反向恢复充电电量 |
此参数与充电时间成正比,影响反向恢复的速度和时间等参数。 |
|
BVDSS |
Drain-Source Breakdown Voltage |
漏源击穿电压 |
漏源间可承受的最大电压,该参数是正温度系数,只要保证足够的余量即可。 |
|
BVDSS /ΔTJ |
Breakdown Voltage Temperature Coefficient |
漏源击穿电压温度系数 |
正温度系数,反映的是BVDSS的温度稳定性。数值越小,稳定性越好。 |
|
IDSS |
Zero Gate Voltage Drain Current |
漏源间的漏电流 |
正温度系数,IDSS越大,MOSFET关断时的损耗越大,导致温升较高。 |
|
IGSS |
Gate-Body leakage current |
栅极漏电流 |
此参数越小越好,影响系统效率。 |
|
VGS(TH) |
Gate Threshold Voltage |
栅极开启电压 |
VGS(TH)越高,MOSFET的米勒平台越高,开启越慢,开关损耗越小。实际应用电压要大于VGS(TH) 一段距离,以防止MOS工作在线性区,造成热失效。 |
|
RDS(ON) |
Static Drain-Source On-Resistance |
导通电阻 |
同样条件下,RDS(ON)越小越好,RDS(ON)越小,导通损耗越小,MOS的参数ID就与RDS(ON)相关。RDS(ON)越小,导通电流越大,同时温升越低。 |
|
Gfs |
Forward Transconductance |
正向跨导 |
反映了栅极电压对MOS漏源电流的控制能力,Gfs较小,则MOSFET的关断速度较低;Gfs过大,则关断过快,EMC性能会很差,同时漏极在关断时产生大的峰值电压。 |
|
Ciss |
Input Capacitance |
输入电容 |
Ciss = Cgs + Cgd,该参数影响MOS的开关时间,相同的驱动能力,Ciss越大,开关就越慢,开关损耗越大,EMC性能越好。 |
|
Coss |
Output Capacitance |
输出电容 |
Coss = Cds + Cgd,Crss= Cgd,Cgd为米勒电容,这两个参数对MOS关断时间有一定的影响,米勒电容影响到漏极有高电压时,传输到栅极的电压。雷击浪涌实验会有影响。 |
|
Crss |
Reverse Transfer Capacitance |
反向传输电容 | |
|
td(on) |
Turn-On DelayTime |
漏源导通延迟时间 |
这些参数与MOS开关时间相关,速度越快,时间越长,开关损耗就大;开关时间越短,损耗越小,EMC性能较差,关断时漏极电压高。 |
|
tr |
Turn-On Rise Time |
漏源电流上升时间 | |
|
Td(off) |
Turn-Off DelayTime |
漏源关断延迟时间 | |
|
tf |
Turn-Off Fall Time |
漏源电流下降时间 | |
|
Qg |
Total Gate Charge |
栅极总充电电量 | |
|
Qgs |
Gate Source Charge |
栅源充电电量 | |
|
Qgd |
Gate Drain Charge |
栅漏充电电量 |
2、MOSFET的在power的应用
TV power的功率范围主要集中在40W到300W之间。根据功率数和实际的应用,分为以下方案:
- 75W以下power,不需要PFC,主要方案是Flyback (反激)。Flyback方案对MOSFET参数要求不高,主要参数:
对于宽范围输入电压90V-264V,如果用600V的MOSFET就要求占空比要小,同时变压器设计时注意MOSFET关断时的震荡(一般要增加RCD吸收电路),电压的尖峰要小,再加上短路时尖峰还要高,所以600V的MOSFET余量就比较小了。所以很多客户要求用650V甚至700V的MOSFET,为的就是增加设计余量。
b)Id ,漏源级电流,由Rdson (导通电阻)计算而得。
在这里主要看两种情况,一个是冲击电流,虽然规格书上要求只要MOSFET结温不超过要求就行,但是一般还是要求不能大于MOSFET的额定电流。在这里一定注意变压器的设计,在任何情况下不能饱和(一般从电流的波形上就可以看出),饱和的结果就是MOS损坏。见下图,红圈内的电流波形,其斜率发生变化,已经饱和。这时正常工作时的波形,开机时应该更严重。

c) 温升,
衡量一个MOS是否工作在安全区域的一个重要指标就是温升,无论在什么情况下,都要保证晶圆的结温工作在安全温度之下,一般在150°C。
但实际上,结温是测试不到的,那就需要测试表面温度,然后根据Rθjc的数值,计算出此时大约的结温。
同一个MOSFET,在不同的条件下,可以输出不同的功率,主要原因就是温升的控制,也就是散热条件的好坏。
d)驱动,
对于驱动,最简单的就是一个驱动电阻,但是一般同时要求关断时要增加栅极的放电速度。所以用一个相对较大的驱动电阻,一个相对较小的放电电阻。
这里要注意,驱动电阻的大小要根据实际MOSFET的要求来选用,每个MOSFET的开关速度,输入电容,栅极电荷都不一样,所以要选用MOSFET推荐范围内的驱动电阻,如果太小工作波形可能会震荡。在这个范围内,驱动电阻的大小就要根据实际情况来选,小的电阻意味着高的效率,但是可能有较差的EMC,这就是个平衡的问题,需要在中间选个平衡点。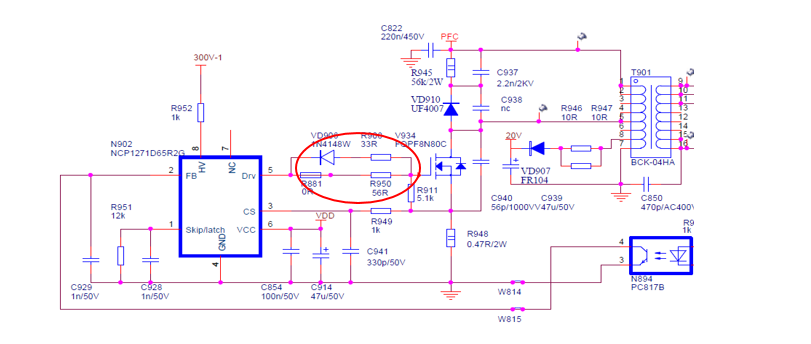
- 75W以上的power,要求增加PFC电路。
因为Vbus的限制和整体的考虑,Vbus一般在380V到390V之间。一般选用600V MOSFET。PFC电路实际就是一个Boost升压电路。现在一般的方案用的是CRM(临界模式)和CCM(连续模式)。对于TV power,CRM可以满足要求,而且对升压二极管要求较低。就应用而讲,PFC MOSFET和Flyback的要求差不多,普通的MOSFET就可以,当然了,超结MOS有更低的Rdson和Qg,温升和效率的表现更好些。
测试MOS电流的时候,也要注意PFC电感的饱和问题。
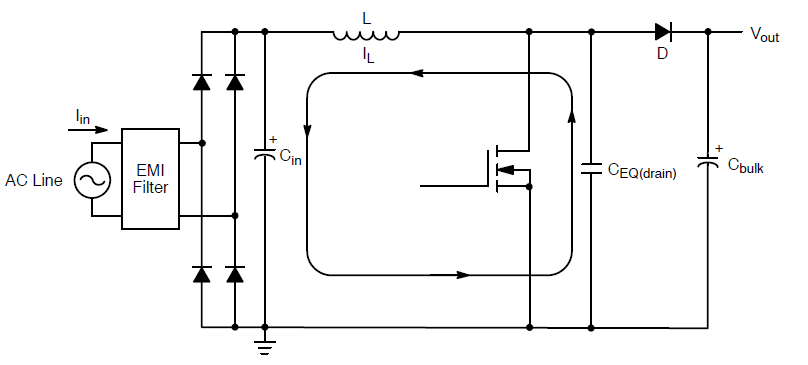
- LLC电路
考虑效率和成本的因素,LLC电路得到了广泛的应用。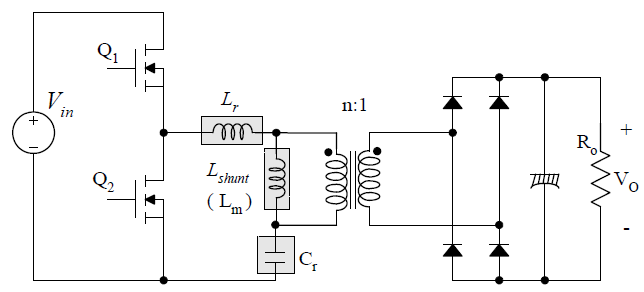
LLC电路就对MOSFET有了一定的要求,尤其是寄生的体二极管。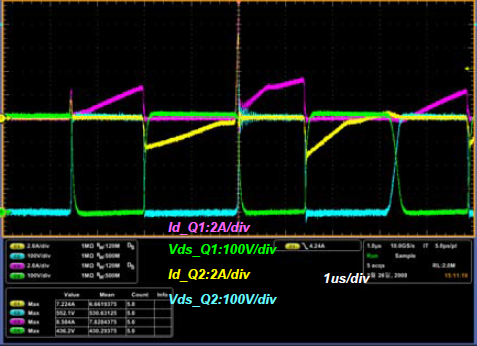

上面的图给出了启动时功率MOSFET前五个开关波形。在变换器启动开始前,谐振电容和输出电容刚好完全放电。与正常工作状况相比,在启动过程中,这些空电容会使低端开关Q2的体二极管深度导通。因此流经开关Q2体二极管的反向恢复电流非常高,致使当高端开关Q1导通时足够引起直通问题。启动状态下,在体二极管反向恢复时,非常可能发生功率MOSFET的潜在失效。
体二极管反向恢复时:
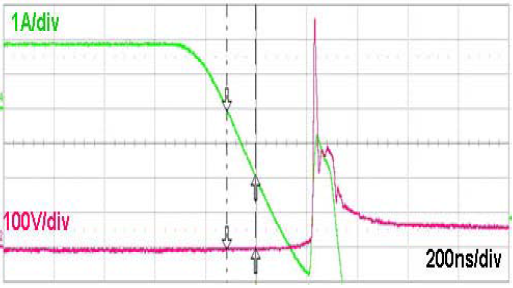
二极管由通态到反向阻断状态的开关过程称为反向恢复。图16给出了MOSFET体二极管反向恢复的波形。首先体二极管正向导通,持续一段时间。这个时段中,二极管P-N结积累电荷。当反向电压加到二极管两端时,释放储存的电荷,回到阻断状态。释放储存电荷时会出现以下两种现象:流过一个大的反向电流和重构。在该过程中,大的反向恢复电流流过MOSFET的体二极管,是因为MOSFET的导通沟道已经切断。一些反向恢复电流从N+源下流过。这就造成两个问题,一个是冲击电流过大,超过MOSFET承受能力,一个是形成热点,反复发热超过结温,最终造成MOSFET击穿损坏。
评论
jason.wu
2020年1月15日