IGBT全称为绝缘栅双极型晶体管,它由绝缘栅型场效应管和双极型三极管两个部分组成,其兼具MOSFET输入阻抗高、控制功率小、驱动电路简单、开关速度快和 BJT通态电流大、导通压降低、损耗小等优点,是功率半导体未来主要的发展方向之一。
GBT技术发展趋势
从正面栅极结构上来看,其结构经历了从平面栅向沟槽栅以及最新的微沟槽栅的演化,目前市场 主流的IGBT芯片以沟槽栅为主。栅极结构从平面向沟槽的发展有利于提高电流密度、降低导通 压降、降低元胞尺并降低制造成本。
从体结构上来看,其经历了从穿通型(PT,Punch Through)到非穿通型(NPT,Non-Punch Through)再到场截止型(FS,Field Stop)三代的演化。
通过不断的技术迭代,IGBT芯片各项性能指标不断优化。从最早的平面穿通型(PT)迭代至精细沟槽栅场截止型,IGBT芯片的各项技术指标如芯片面积、工艺线宽、导通压降、 关断时间和功率损耗等均得到了不断优化。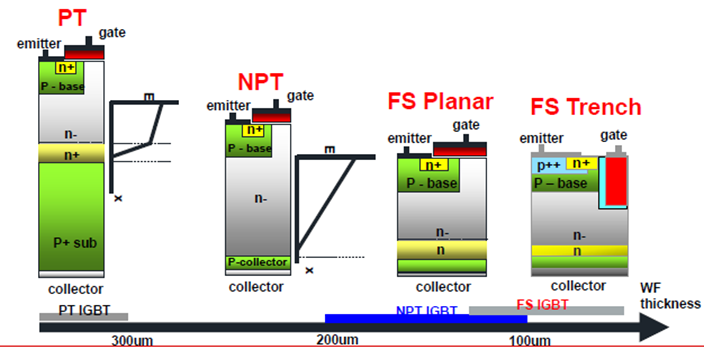

穿通型(PT,Punch Through)
PT是最初代的IGBT,它使用重掺杂的P+衬底作为起始层,在此之上依次生长N+ buffer,N- base外延,最后在外延层表面形成元胞结构。它因为截止时电场贯穿整个N-base区而得名。它工艺复杂,成本高,而且需要载流子寿命控制,饱和压降呈负温度系数,不利于并联,虽然在上世纪80年代一度呼风唤雨,但在80年代后期逐渐被NPT取代,目前已归隐江湖,不问世事,目前市面流通的IGBT产品几乎没有使用PT技术。
平面栅,非穿通结构(NPT)
NPT-IGBT于1987年出山,很快在90年代成为江湖霸主。NPT与PT不同在于,它使用低掺杂的N-衬底作为起始层,先在N-漂移区的正面做成MOS结构,然后用研磨减薄工艺从背面减薄到 IGBT 电压规格需要的厚度,再从背面用离子注入工艺形成P+ collector。在截止时电场没有贯穿N-漂移区,因此称为“非穿通”型IGBT。NPT不需要载流子寿命控制,但它的缺点在于,如果需要更高的电压阻断能力,势必需要电阻率更高且更厚的N-漂移层,这意味着饱和导通电压Vce(sat)也会随之上升,从而大幅增加器件的损耗与温升。因为N-漂移区厚度大大降低了,因此Vce(sat)相比PT大大减少。正温度系数,利于并联。
沟槽栅,场截止(Field Stop)
沟槽型IGBT中,电子沟道垂直于硅片表面,消除了JFET结构,增加了表面沟道密度,提高近表面载流子浓度,从而使性能更加优化。纵向结构方面,为了缓解阻断电压与饱和压降之间的矛盾,英家于2000年推出了Field Stop IGBT,目标在于尽量减少漂移区厚度,从而降低饱和电压。场截止(Field Stop)IGBT起始材料和NPT相同,都是低掺杂的N-衬底,不同在于FS IGBT背面多注入了一个N buffer层,它的掺杂浓度略高于N-衬底,因此可以迅速降低电场强度,使整体电场呈梯形,从而使所需的N-漂移区厚度大大减小。此外,N buffer还可以降低P发射极的发射效率,从而降低了关断时的拖尾电流及损耗。
评论